| 感光性の材料(レジスト)をウェハに塗布し、光や電子ビームを照射してパターンを形成します。 | 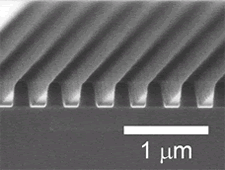 |
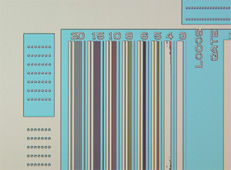 |
| 電子ビーム露光装置 (日立 HL700) | 電子ビーム露光装置 (日本電子 JBX5D) | |||||
| 可変成形型,加速電圧:50 kV,最小線幅:50 nm | ポイントビーム型,加速電圧:25 kV or 50 kV,最小線幅:30 nm | |||||
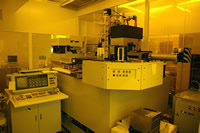 |
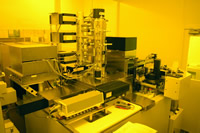 |
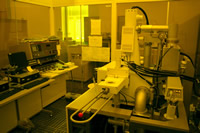 |
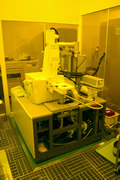 |
|||
| i線ステッパー (Nikon NSR i8a) | ||||||
| 最小線幅:350 nm | ||||||
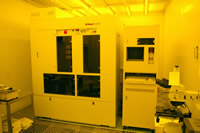 |
||||||